Bonding 键合(粘接)设备
凭借我们在设计和制造晶圆键合设备方面的丰富经验,EVG在制定晶圆键合行业标准方面广受认可。
EVG晶圆键合系统可以配置用于研发,中试线或大批量生产,以及任何基于直接或中间层的键合工艺,包括复杂的低温共价键合。凭借这些技术和设备组合,EVG占领了封装和3D集成,MEMS以及的化合物半导体和SOI基板的市场,保持了地位和主导。
粘接系统
EVG的晶圆键合机可提供的总体拥有成本(TCO),并具有多种设计功能可优化键合良率。针对MEMS,3D集成或高级封装中的不同市场需求,针对键合对准的多个模块进行了优化。
临时粘接系统
临时键合是为薄晶圆或薄薄晶圆提供机械支撑的的过程,这对于3D IC,功率器件和FoWLP晶圆以及处理易碎基板(例如化合物半导体)非常重要。EVG粘合技术在其临时粘合设备中得到了体现,该设备自2001年以来一直由该公司提供。
EVG850 DB
键对准系统
1985年,EV Group发明了世界上个双面对准系统,改变了MEMS技术,并通过分离对准和键合工艺,在对准晶片键合方面树立了行业标准。
SmartView NT
融合和混合键合系统
融合或直接晶圆键合可通过每个晶圆表面上的介电层连接,用于工程衬底或层转移,例如背面照明的CMOS图像传感器。混合键合扩展了键合界面中嵌入金属焊盘的熔融键合,从而实现了面对面晶片的正面连接。混合绑定的主要应用是高级3D设备堆叠。
Permanent Bonding Systems
键合系统
粘接系统
EVG的晶圆键合的引入将键合对准与键合步骤分离开来,立即掀起了市场革命。利用高温和受控气氛下的高接触力,这种新颖的已成为当今的工艺标准,EVG占据了半自动和全自动晶圆键合机的主要,并且安装的基础已经超过1500个。EVG的晶圆键合机可提供的总体拥有成本(TCO),并具有多种设计功能可优化键合良率。针对MEMS,3D集成或高级封装中的不同市场需求,针对键合对准的多个模块进行了优化。的小于100 nm的对准精度和经过大量验证的模块化平台使EVG的晶圆键合技术可以在各种应用中进行组合。
EVG®501 晶圆键合系统
适用于学术界和工业研究的多功能手动晶圆键合系统
EVG®510 晶圆键合系统
用于研发或小批量生产的晶圆键合系统-与大批量制造设备兼容。
EVG®520IS 晶圆键合系统
单腔或双腔晶圆键合系统,用于小批量生产。
EVG®540 自动晶圆键合系统
全自动晶圆键合系统,适用于300 mm的基板。
EVG®560 自动晶圆键合系统
全自动晶圆键合系统,用于大批量生产。
ComBond® 自动化的高真空晶圆键合系统
高真空晶圆键合平台可促进“任何事物上的任何事物"的共价键连接。
GEMINI® 自动化生产晶圆键合系统
集成的模块化大批量生产系统,用于对准晶圆键合。








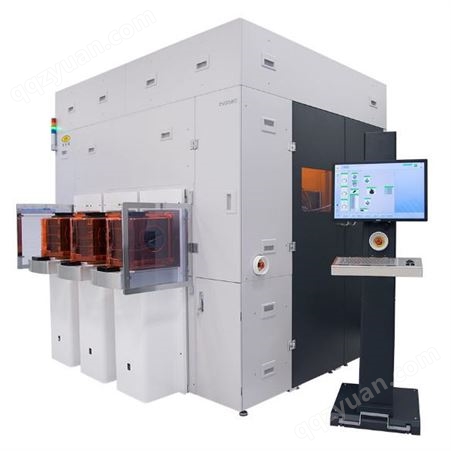





所有评论仅代表网友意见,与本站立场无关。